一、玻璃基板:先進封裝的變革,重新定義(yi) 基板
(一)英特爾持續加碼玻璃基板,高舉(ju) 封裝工藝變革旗幟
英特爾一直是玻璃基板領域的探索引領者。根據三疊紀官網,早在十年前英特爾就開始尋找有機基板的替代品,並在亞(ya) 利桑那州的CH8工廠投資十億(yi) 美元試生產(chan) 玻璃基板。作為(wei) 封裝基板領域的探索引領者,2023年9月英特爾展示了一款功能齊全的基於(yu) 玻璃基板的測試芯片,並計劃於(yu) 2030年開始批量生產(chan) ,該芯片使用75微米的玻璃通孔,深寬比為(wei) 20:1,核心厚度為(wei) 1毫米。英特爾的新技術不僅(jin) 僅(jin) 停留在玻璃基板的層麵,還引入了FoverosDirect(一種具有直接銅對銅鍵合功能的高級封裝技術),為(wei) CPO(Co-packagedOptics,可共同封裝光學元件技術)通過玻璃基板設計利用光學傳(chuan) 輸的方式增加信號,並聯合康寧通過CPO工藝集成電光玻璃基板探索400G及以上的集成光學解決(jue) 方案。英特爾與(yu) 設備材料合作夥(huo) 伴展開了密切合作,與(yu) 玻璃加工廠LPKF和德國玻基公司Schott共同致力於(yu) 玻璃基板的產(chan) 品化。另外,英特爾還帶頭組建了一個(ge) 生態係統,已經擁有大多數主要的EDA和IP供應商、雲(yun) 服務提供商和IC設計服務提供商。
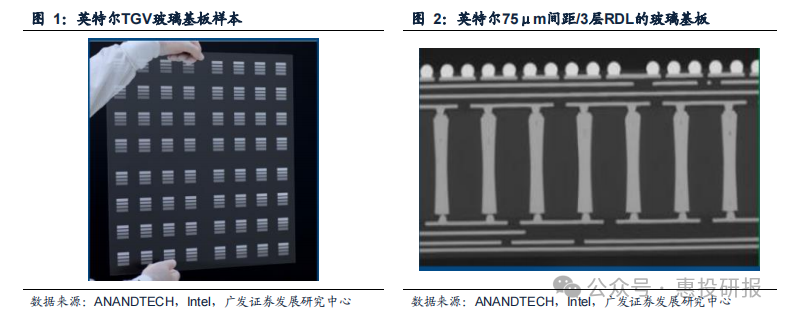
英特爾認為(wei) 玻璃基板有望成為(wei) 下一代主流的基板材質。根據ANANDTECH引用的Intel展示PPT,複盤芯片基板的發展曆史,自1970年引線框架大規模使用於(yu) 芯片封裝後,英特爾認為(wei) 半導體(ti) 行業(ye) 主流的基板技術將會(hui) 每15年改變一次,未來行業(ye) 將會(hui) 迎來玻璃基板的轉變,而從(cong) 有機板到玻璃基板的這個(ge) 轉變將在近10年發生,同時英特爾也認為(wei) 玻璃基板的出現並不會(hui) 馬上完全取代有機板,而是會(hui) 在未來一段時間內(nei) 和有機板共存。

玻璃基板、CPO工藝有望成為(wei) 混合鍵合以後的下一代先進封裝工藝。根據ANANDTECH引用的Intel展示PPT,英特爾認為(wei) 基於(yu) 玻璃基板、CPO將是先進封裝下一代主流技術。相比有機板和矽,玻璃基板的性能和密度均有提高,可以允許在更小的占用麵積下封裝更多的Chiplets,以此帶來更低的整體(ti) 成本的功耗,讓未來數據中心和AI產(chan) 品得到大幅改進。根據未來半導體(ti) ,英特爾研發的CPO也可以通過玻璃基板進行設計,從(cong) 而實現利用光學傳(chuan) 輸的方式來增加信號,提高功率的同時降低成本。
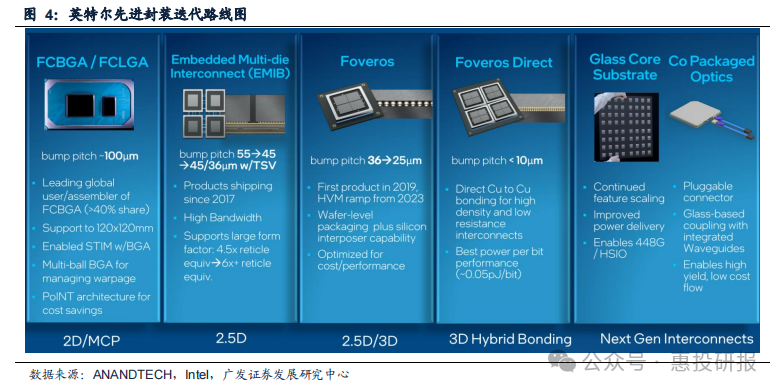
(二)玻璃基板:材料與(yu) 工藝的變革
玻璃基板主要用來取代原先的矽/有機物基板和中介層,可應用於(yu) 麵板、IC等泛半導體(ti) 領域。在目前的2.5D封裝中,以較為(wei) 主流的台積電的CoWoS封裝為(wei) 例,是先將半導體(ti) 芯片(CPU、GPU、存儲(chu) 器等)通過ChiponWafer(CoW)的封裝製程一起連接至中介層(Interposer)上,再通過WaferonSubstrate(WoS)的封裝製程將矽中介層連接至底層基板上;其中,中介層(interposer)一般選用矽(COWOS-S)、有機物(COWOS-R)或者是矽和有機物的結合(COWOS-L)。
玻璃材質的引入可以取代原先的矽中介層和有機基板。玻璃基板直接利用玻璃中介層(GlassInterposer)實現芯片之間、芯片與(yu) 外部的互聯,利用玻璃材質成本低、電學性能好、翹曲低等優(you) 點來克服有機物材質和矽材質的缺陷,來實現更穩定、更高效的連接以及降低生產(chan) 成本,有望為(wei) 2.5D/3D封裝帶來全新的範式改變。
玻璃基板的3D封裝方麵,TGV及其相關(guan) 的RDL將成為(wei) 關(guan) 鍵工藝。目前的3D封裝中,以HBM工藝為(wei) 例,其中的關(guan) 鍵技術包括TSV(Through-SiliconVias)、微凸點(Microbumps)、TCB鍵合(Thermo-CompressionBonding,熱壓鍵合)、混合鍵合(hybridbonding)等;對於(yu) 玻璃基板的3D封裝,TGV(ThroughGlassVia,玻璃通孔)、銅孔的填充及其RDL將成為(wei) 關(guan) 鍵工藝。

玻璃基板優(you) 勢顯著。根據《玻璃通孔技術研究進展》(陳力等),玻璃基板的優(you) 勢主要體(ti) 現在:
(1)低成本:受益於(yu) 大尺寸超薄麵板玻璃易於(yu) 獲取,以及不需要沉積絕緣層,玻璃轉接板的製作成本大約隻有矽基轉接板的1/8;
(2)優(you) 良的高頻電學特性:玻璃材料是一種絕緣體(ti) 材料,介電常數隻有矽材料的1/3左右,損耗因子比矽材料低2~3個(ge) 數量級,使得襯底損耗和寄生效應大大減小,可以有效提高傳(chuan) 輸信號的完整性;
(3)大尺寸超薄玻璃襯底易於(yu) 獲取:康寧、旭硝子以及肖特等玻璃廠商可以量產(chan) 超大尺寸(大於(yu) 2m×2m)和超薄(小於(yu) 50μm)的麵板玻璃以及超薄柔性玻璃材料;
(4)工藝流程簡單:不需要在襯底表麵及TGV內(nei) 壁沉積絕緣層,且超薄轉接板不需要二次減薄;
(5)機械穩定性強:當轉接板厚度小於(yu) 100μm時,翹曲依然較小;
(6)應用領域廣泛:除了在高頻領域有良好應用前景之外,透明、氣密性好、耐腐蝕等性能優(you) 點使玻璃通孔在光電係統集成領域、MEMS封裝領域有巨大的應用前景。

來源:惠投研報
免責申明:文章版權歸原作者所有,如您(單位或個(ge) 人)認為(wei) 內(nei) 容有侵權嫌疑,敬請立即通知我們(men) ,我們(men) 將第一時間予以更改或刪除。